
热疲劳损伤是电子焊点中常见的失效模式,但微观结构的作用尚不完全清楚。近日,来自伦敦帝国理工学院的C. M. Gourlay等人使用局部亚晶粒、再结晶和严重粗化的Ag3Sn的EBSD映射,量化了整个球栅阵列(BGA)封装中Sn-3Ag-0.5Cu接头的微观结构和损伤的演变过程。
文章要点:
1) 该研究使用多尺度建模方法来解释这些研究结果,该方法从封装/大规模的连续体模型链接到微观结构规模的晶体塑性有限元模型,测量并解释了损伤演化对单晶粒和多晶粒接头中的β-Sn晶体取向的依赖性,以及循环孪晶多晶粒接头中锡晶粒之间的热膨胀系数(CTE)失配的依赖性;
2) 此外,该研究进一步探讨了焊料微观结构相对于阵列中接头位置的相对重要性,这些研究结果为设计具有热疲劳抗力的最佳焊点微观结构提供了依据。
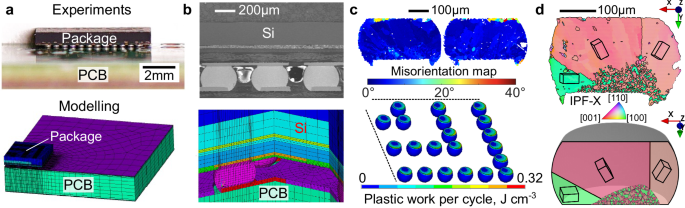
参考资料:
Xian, J.W., Xu, Y.L., Stoyanov, S. et al. The role of microstructure in the thermal fatigue of solder joints. Nat Commun 15, 4258 (2024).
10.1038/s41467-024-48532-6
https://doi.org/10.1038/s41467-024-48532-6


















